QR kode

Produkter
Kontakt oss


Faks
+86-579-87223657

E-post

Adresse
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Kjemisk mekanisk polering (CMP) fjerner overflødig materiale og overflatedefekter gjennom den kombinerte virkningen av kjemiske reaksjoner og mekanisk slitasje. Det er en nøkkelprosess for å oppnå global planarisering av waferoverflaten og er uunnværlig for flerlags kobberforbindelser og lav-k dielektriske strukturer. I praktisk produksjon er CMP ikke en perfekt enhetlig fjerningsprosess; det gir opphav til typiske mønsteravhengige defekter, blant disse er utskjæring og erosjon de mest fremtredende. Disse defektene påvirker direkte geometrien til sammenkoblingslagene og deres elektriske egenskaper.
Dishing refererer til overdreven fjerning av relativt myke ledende materialer (som kobber) under CMP, noe som fører til en tallerkenformet konkav profil inne i en enkelt metalllinje eller et stort metallområde. I tverrsnitt ligger midten av metalllinjen lavere enn dens to kanter og den omgivende dielektriske overflaten. Dette fenomenet observeres ofte i brede linjer, puter eller metallområder av blokktype. Formasjonsmekanismen er hovedsakelig relatert til forskjeller i materialhardhet og deformasjon av poleringsputen over brede metallegenskaper: myke metaller er mer følsomme for de kjemiske komponentene og slipemidlene i slurryen, og det lokale kontakttrykket til puten øker på brede funksjoner, noe som fører til at fjerningshastigheten i midten av metallet overskrider den ved kantene. Som et resultat øker dybden på oppvasken vanligvis med linjebredden og tiden for overpolering.
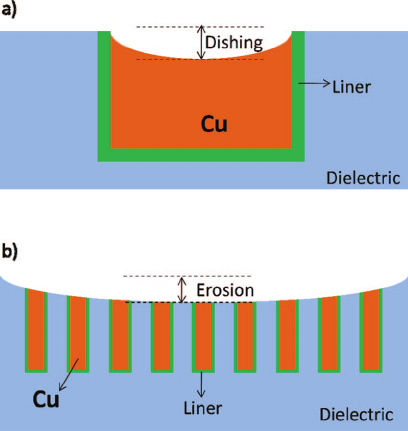
Erosjon er karakterisert ved at den totale overflatehøyden i områder med høy mønstertetthet (som tette metalllinjearrayer eller områder med tett dummyfyll) er lavere enn i omkringliggende tynt regioner etter CMP. I hovedsak er det en mønstertetthetsdrevet overfjerning av materiale på regionnivå. I tette områder gir metall og dielektrisk sammen et større effektivt kontaktareal, og den mekaniske friksjonen og kjemiske virkningen av puten og slurryen er sterkere. Følgelig er den gjennomsnittlige fjerningshastigheten for både metall og dielektrisk høyere enn i områder med lav tetthet. Etter hvert som polering og overpolering fortsetter, blir den metall-dielektriske stabelen i tette områder tynnere som helhet, og danner et målbart høydetrinn, og graden av erosjon øker med lokal mønstertetthet og prosessbelastning.
Sett fra enhetens og prosessytelsens perspektiv, har dishing og erosjon flere negative innvirkninger på halvlederprodukter. Dishing reduserer det effektive tverrsnittsarealet til metallet, noe som fører til høyere sammenkoblingsmotstand og IR-fall, som igjen forårsaker signalforsinkelse og redusert tidsmargin på kritiske baner. Variasjoner i dielektrisk tykkelse forårsaket av erosjon endrer den parasittiske kapasitansen mellom metalllinjer og fordelingen av RC-forsinkelse, og undergraver jevnheten til elektriske egenskaper over brikken. I tillegg påvirker lokal dielektrisk tynning og elektrisk feltkonsentrasjon nedbrytningsadferden og langsiktig pålitelighet av intermetalliske dielektriske stoffer. På integreringsnivået øker overdreven overflatetopografi vanskeligheten med litografisk fokus og justering, forringer ensartetheten til påfølgende filmavsetning og etsing, og kan indusere defekter som metallrester. Disse problemene manifesterer seg til slutt som avkastningsfluktuasjoner og et krympende prosessvindu. Derfor, i praktisk prosjektering, er det nødvendig å kontrollere dishing og erosjon innenfor spesifiserte grenser gjennom layout-tetthetsutjevning, optimalisering avpolering slurerselektivitet og finjustering av CMP-prosessparametere, for å sikre planariteten til sammenkoblingsstrukturer, stabil elektrisk ytelse og robust høyvolumsproduksjon.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Alle rettigheter reservert.
Links | Sitemap | RSS | XML | Personvernerklæring |
