QR kode

Produkter
Kontakt oss


Faks
+86-579-87223657

E-post

Adresse
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Etsingteknologi er et av nøkkeltrinnene i halvlederproduksjonsprosessen, som brukes til å fjerne spesifikke materialer fra waferen for å danne et kretsmønster. Men under tørretsingsprosessen møter ingeniører ofte problemer som belastningseffekt, mikrosporeffekt og ladeeffekt, som direkte påvirker kvaliteten og ytelsen til sluttproduktet.
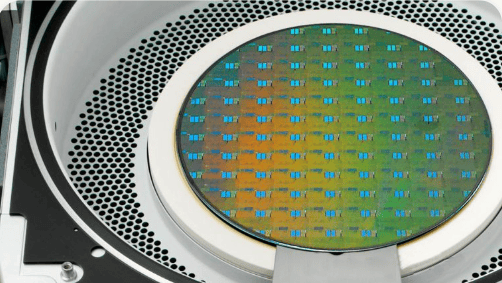
Belastningseffekt refererer til fenomenet at når etsningsområdet øker eller etsningsdybden øker under tørr etsning, synker etsningshastigheten eller etsingen er ujevn på grunn av utilstrekkelig tilførsel av reaktiv plasma. Denne effekten er vanligvis relatert til egenskapene til etsesystemet, for eksempel plasmatetthet og ensartethet, vakuumgrad, etc., og er bredt til stede i forskjellige reaktiv ion -etsing.
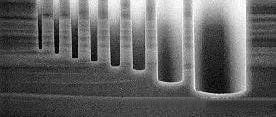
•Forbedre plasmatetthet og ensartethet: Ved å optimalisere utformingen av plasmakilden, for eksempel å bruke mer effektiv RF-kraft eller magnetronforstøvningsteknologi, kan en høyere tetthet og mer jevnt fordelt plasma genereres.
•Juster sammensetningen av den reaktive gassen: Tilsetting av en passende mengde hjelpegass til den reaktive gassen kan forbedre plasmaets ensartethet og fremme effektiv utslipp av etsningsbiprodukter.
•Optimaliser vakuumsystemet: Forbedring av pumpehastigheten og effektiviteten til vakuumpumpen kan bidra til å redusere oppholdstiden for etsende biprodukter i kammeret, og dermed redusere belastningseffekten.
•Design en rimelig fotolitografioppsett: Når du designer fotolitografisk utforming, bør mønsterets tetthet tas med i betraktningen for å unngå over tett arrangement i lokale områder for å redusere effekten av belastningseffekten.
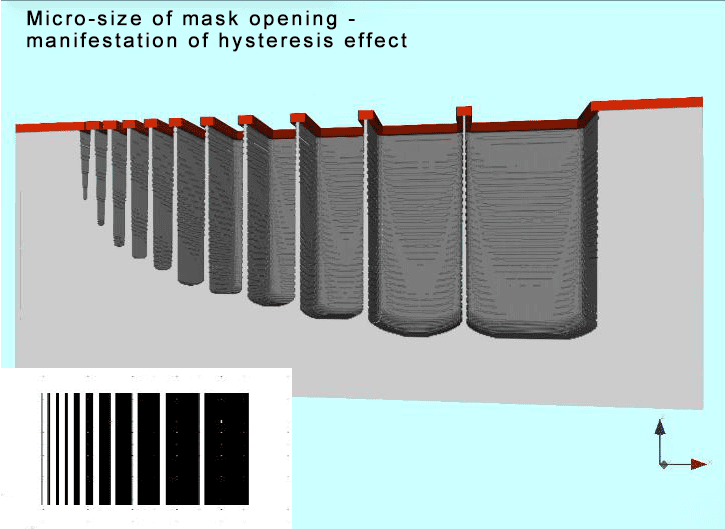
Mikrogrøftingseffekten refererer til fenomenet at under etseprosessen, på grunn av høyenergipartiklene som treffer etseoverflaten i en skrå vinkel, er etsehastigheten nær sideveggen høyere enn i det sentrale området, noe som resulterer i ikke -vertikale avfasninger på sideveggen. Dette fenomenet er nært knyttet til vinkelen til de innfallende partiklene og helningen til sideveggen.
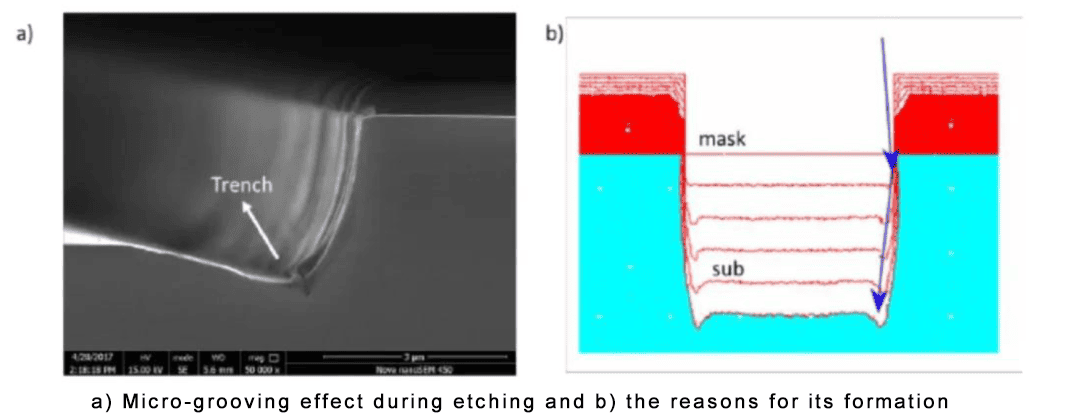
•Øk RF-effekten: Riktig økning av RF-effekten kan øke energien til de innfallende partiklene, slik at de kan bombardere måloverflaten mer vertikalt, og dermed redusere etsningshastigheten forskjellen til sideveggen.
•Velg riktig materiale for etsemaske: Noen materialer kan bedre motstå ladeeffekten og redusere mikrograveeffekten som forverres av akkumulering av negativ ladning på masken.
•Optimaliser etseforholdene: Ved å justere parametere som temperatur og trykk under etsningsprosessen, kan selektiviteten og ensartetheten av etsing effektivt kontrolleres.
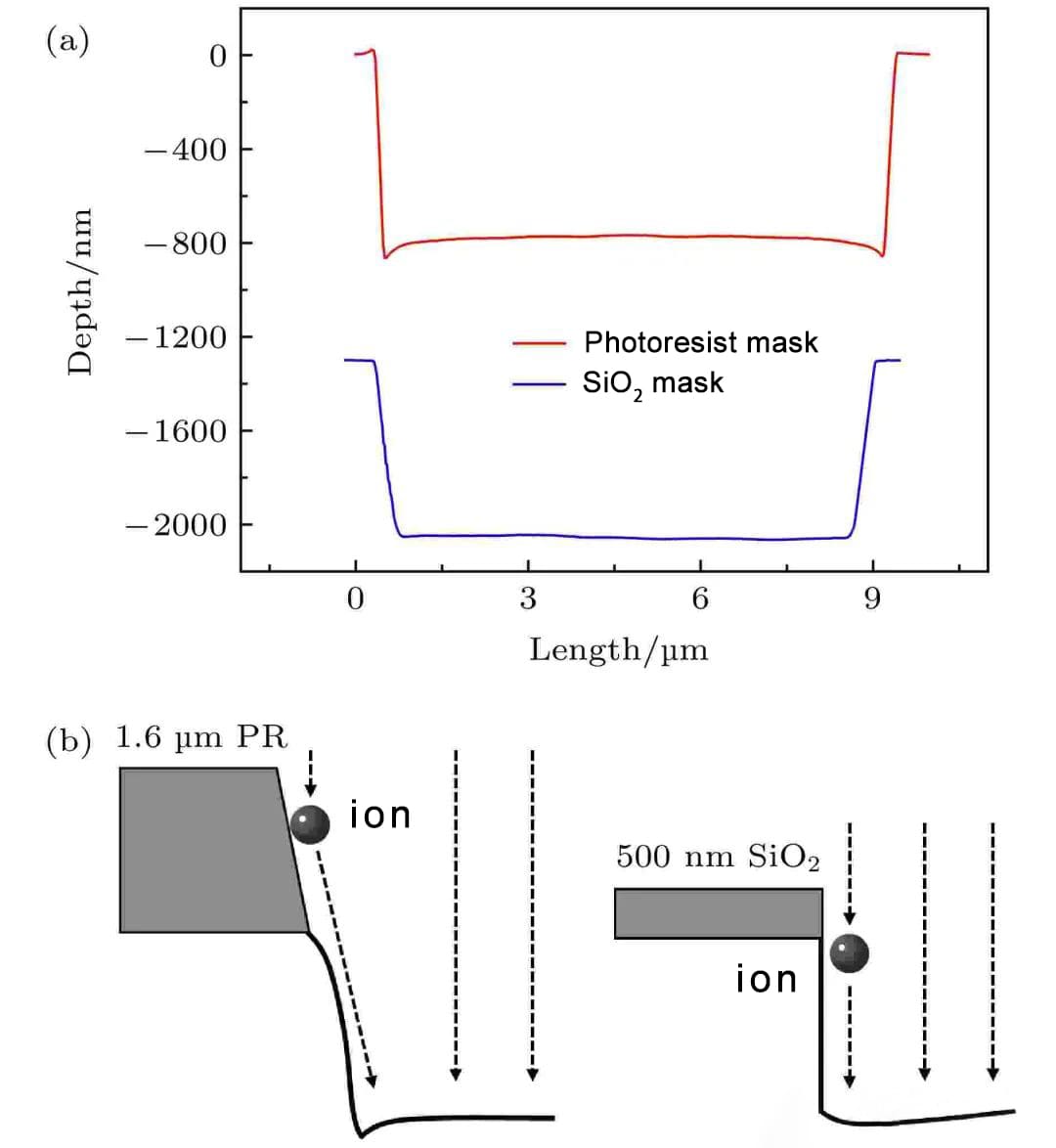
Ladeeffekten er forårsaket av de isolerende egenskapene til etsemasken. Når elektronene i plasmaet ikke kan slippe unna raskt, samles de på maskeoverflaten for å danne et lokalt elektrisk felt, forstyrre banen til de innfallende partiklene, og påvirke anisotropien av etsing, spesielt når det etset fine strukturer.
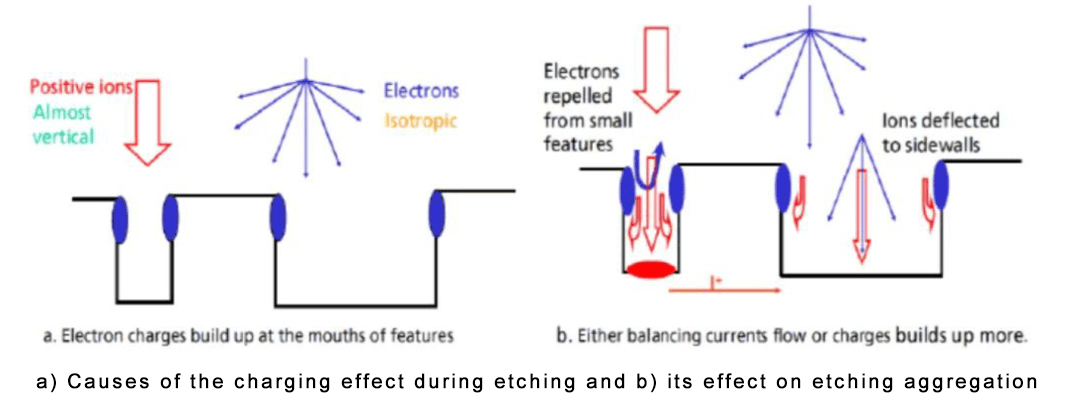
• Velg passende materialer for etsemaske: Noen spesialbehandlede materialer eller ledende maskelag kan effektivt redusere aggregeringen av elektroner.
•Implementer intermitterende etsing: Ved periodisk å avbryte etseprosessen og gi elektroner nok tid til å unnslippe, kan ladeeffekten reduseres betydelig.
•Juster etsemiljøet: Endring av gasssammensetning, trykk og andre forhold i etsemiljøet kan bidra til å forbedre stabiliteten til plasmaet og redusere forekomsten av ladeeffekten.
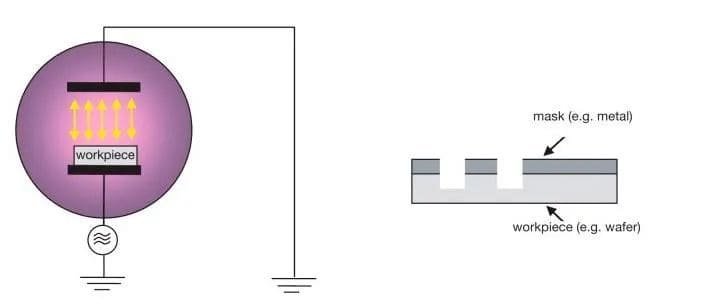



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Alle rettigheter reservert.
Links | Sitemap | RSS | XML | Personvernerklæring |
