QR kode

Produkter
Kontakt oss


Faks
+86-579-87223657

E-post

Adresse
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Produksjonen av hvert halvlederprodukt krever hundrevis av prosesser, og hele produksjonsprosessen er delt inn i åtte trinn:skivebehandling - oksidasjon - fotolitografi - etsing - Tynn filmavsetning - samtrafikk - testing - emballasje.
![]()
Trinn 1:Skivebehandling
Alle halvlederprosesser starter med et sandkorn! Fordi silisiumet som er inneholdt i sanden er råstoffet som trengs for å produsere skiver. Vafere er runde skiver kuttet fra enkeltkrystallsylindere laget av silisium (Si) eller galliumarsenid (GAAS). For å hente ut silisiummaterialer med høy renhet, er silikasand, et spesielt materiale med et silisiumdioksidinnhold på opptil 95%, nødvendig, som også er det viktigste råstoffet for å lage skiver. Wafer -prosessering er prosessen med å lage de ovennevnte skiver.
Ingot Casting
For det første må sanden varmes opp for å skille karbonmonoksid og silisium i den, og prosessen gjentas til ultrahøy renhet elektronisk silisium (EG-Si) oppnås. Silisium med høy renhet smelter i væske og stivner deretter til en enkelt krystallfast form, kalt en "ingot", som er det første trinnet i halvlederproduksjon.
Produksjonspresisjonen av silisiuminngaver (silisiumsøyler) er veldig høy, og når nanometernivået, og den mye brukte produksjonsmetoden er czochRalski -metoden.
Ingotskjæring
Etter at forrige trinn er fullført, er det nødvendig å kutte av de to endene av ingot med en diamantsag og deretter kutte den i tynne skiver av en viss tykkelse. Diameteren til ingotskiven bestemmer størrelsen på skiven. Større og tynnere skiver kan deles inn i mer brukbare enheter, noe som bidrar til å redusere produksjonskostnadene. Etter å ha kuttet silisiuminngiften, er det nødvendig å legge til "flatt område" eller "Dent" -merker på skivene for å lette å sette behandlingsretningen som en standard i påfølgende trinn.
Wafer Surface Polishing
Skivene oppnådd gjennom den ovennevnte skjæreprosessen kalles "bare skiver", det vil si uprosessert "rå skiver". Overflaten på den nakne skiven er ujevn, og kretsmønsteret kan ikke skrives ut direkte på den. Derfor er det nødvendig å først fjerne overflatedefekter gjennom sliping og kjemisk etsningsprosesser, deretter polere for å danne en glatt overflate, og deretter fjerne restforurensninger gjennom rengjøring for å oppnå en ferdig skive med en ren overflate.
Trinn 2: Oksidasjon
Oksidasjonsprosessens rolle er å danne en beskyttende film på overflaten av skiven. Det beskytter skiven mot kjemiske urenheter, forhindrer lekkasjestrøm fra å komme inn i kretsen, forhindrer diffusjon under ionimplantasjon, og forhindrer at skiven sklir under etsing.
Det første trinnet i oksidasjonsprosessen er å fjerne urenheter og forurensninger. Det krever fire trinn for å fjerne organisk materiale, metallforurensninger og fordampe gjenværende vann. Etter rengjøring kan skiven plasseres i et miljø med høy temperatur på 800 til 1200 grader, og et silisiumdioksid (dvs. "oksid") lag dannes ved strømmen av oksygen eller damp på overflaten av skiven. Oksygen diffunderer gjennom oksydlaget og reagerer med silisium for å danne et oksydlag med varierende tykkelse, og dets tykkelse kan måles etter at oksidasjonen er fullført.

Tørr oksidasjon og våt oksidasjon Avhengig av de forskjellige oksidantene i oksidasjonsreaksjonen, kan den termiske oksidasjonsprosessen deles inn i tørr oksidasjon og våt oksidasjon. Førstnevnte bruker rent oksygen for å produsere et silisiumdioksidlag, noe som er tregt, men oksydlaget er tynt og tett. Sistnevnte krever både oksygen og sterkt oppløselig vanndamp, som er preget av en rask veksthastighet, men et relativt tykt beskyttende lag med lav tetthet.
I tillegg til oksidanten, er det andre variabler som påvirker tykkelsen på silisiumdioksidlaget. For det første vil skivestrukturen, dens overflatedefekter og intern dopingkonsentrasjon påvirke hastigheten på oksydlagsgenerering. I tillegg, jo høyere trykk og temperatur som genereres av oksidasjonsutstyret, desto raskere vil oksydlaget bli generert. Under oksidasjonsprosessen er det også nødvendig å bruke et dummyark i henhold til skivenes plassering i enheten for å beskytte skiven og redusere forskjellen i oksidasjonsgrad.
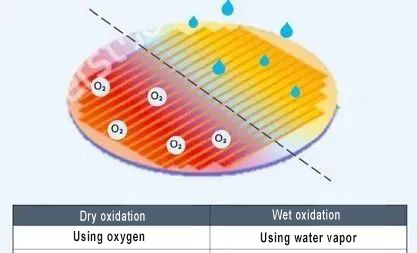
Trinn 3: Fotolitografi
Fotolitografi er å "skrive ut" kretsmønsteret på skiven gjennom lys. Vi kan forstå det som å tegne plansartet som kreves for halvlederproduksjon på overflaten av skiven. Jo høyere finhet av kretsmønsteret, jo høyere integrering av den ferdige brikken, som må oppnås gjennom avansert fotolitografiteknologi. Spesifikt kan fotolitografi deles inn i tre trinn: belegg fotoresist, eksponering og utvikling.
Belegg
Det første trinnet med å tegne en krets på en skive er å belegge fotoresisten på oksydlaget. Photoresist gjør skiven til et "fotopapir" ved å endre kjemiske egenskaper. Jo tynnere fotoresistlaget på overflaten av skiven, desto mer jevn belegget, og jo finere mønsteret som kan skrives ut. Dette trinnet kan gjøres ved "spinnbelegg" -metoden. I henhold til forskjellen i lys (ultrafiolett) reaktivitet, kan fotoresister deles inn i to typer: positive og negative. Førstnevnte vil dekomponere og forsvinne etter eksponering for lys, og etterlate mønsteret i det ueksponerte området, mens sistnevnte vil polymerisere etter eksponering for lys og få mønsteret til den utsatte delen til å vises.
Eksponering
Etter at fotoresistfilmen er dekket på skiven, kan kretsutskriften fullføres ved å kontrollere lyseksponeringen. Denne prosessen kalles "eksponering". Vi kan selektivt passere lys gjennom eksponeringsutstyret. Når lyset passerer gjennom masken som inneholder kretsmønsteret, kan kretsen skrives ut på skiven belagt med fotoresistfilmen nedenfor.
Under eksponeringsprosessen, jo finere det trykte mønsteret, jo flere komponenter kan den endelige brikken romme, noe som bidrar til å forbedre produksjonseffektiviteten og redusere kostnadene for hver komponent. På dette feltet er den nye teknologien som for tiden tiltrekker seg mye oppmerksomhet EUV -litografi. Lam Research Group har i fellesskap utviklet en ny tørrfilm fotoresistteknologi med strategiske partnere ASML og IMEC. Denne teknologien kan forbedre produktiviteten og utbyttet av EUV-litografieksponeringsprosessen ved å forbedre oppløsningen (en nøkkelfaktor i finjusteringskretsbredde).
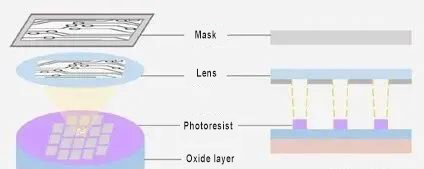
Utvikling
Trinnet etter eksponering er å spraye utvikleren på skiven, formålet er å fjerne fotoresisten i det avdekkede området av mønsteret, slik at det trykte kretsmønsteret kan avsløres. Etter at utviklingen er fullført, må den kontrolleres av forskjellige måleutstyr og optiske mikroskop for å sikre kvaliteten på kretsdiagrammet.
Trinn 4: Etsing
Etter at fotolitografien til kretsdiagrammet er fullført på skiven, brukes en etsningsprosess for å fjerne overflødig oksidfilm og bare la halvlederkretsdiagrammet. For å gjøre dette brukes væske, gass eller plasma for å fjerne de valgte overflødige delene. Det er to hovedmetoder for etsing, avhengig av stoffene som brukes: våt etsing ved bruk av en spesifikk kjemisk løsning for å reagere kjemisk for å fjerne oksidfilmen, og tørr etsing ved bruk av gass eller plasma.
Våt etsing
Våt etsing ved bruk av kjemiske løsninger for å fjerne oksydfilmer har fordelene med lave kostnader, rask etsningshastighet og høy produktivitet. Imidlertid er våt etsing isotropisk, det vil si at hastigheten er den samme i alle retninger. Dette fører til at masken (eller sensitiv film) ikke er helt på linje med den etsede oksydfilmen, så det er vanskelig å behandle veldig fine kretsdiagrammer.

Tørr etsing
Tørr etsing kan deles inn i tre forskjellige typer. Den første er kjemisk etsing, som bruker etsegasser (hovedsakelig hydrogenfluorid). Som våt etsing er denne metoden isotropisk, noe som betyr at den ikke er egnet for fin etsing.
Den andre metoden er fysisk sputtering, som bruker ioner i plasma for å påvirke og fjerne overflødig oksydlag. Som en anisotropisk etsningsmetode har sputtering etsing forskjellige etsningshastigheter i horisontale og vertikale retninger, så dens finhet er også bedre enn kjemisk etsing. Ulempen med denne metoden er imidlertid at etsningshastigheten er langsom fordi den helt er avhengig av den fysiske reaksjonen forårsaket av ionekollisjon.
Den siste tredje metoden er reaktiv ioneting (RIE). RIE kombinerer de to første metodene, det vil si mens du bruker plasma for fysisk etsing av ionisering, utføres kjemisk etsing ved hjelp av frie radikaler generert etter plasma -aktivering. I tillegg til etsningshastigheten som overstiger de to første metodene, kan RIE bruke de anisotropiske egenskapene til ioner for å oppnå etsning med høyt presisjonsmønster.
I dag har tørr etsing blitt mye brukt for å forbedre utbyttet av fine halvlederkretser. Å opprettholde etsningsenhetens ensartethet og økende etsningshastighet er kritisk, og dagens mest avanserte tørre etsningsutstyr støtter produksjonen av de mest avanserte logikk- og minnebrikkene med høyere ytelse.

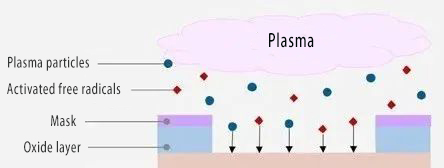
Vetek Semiconductor er en profesjonell kinesisk produsent avTantal karbidbelegg, Silisiumkarbidbelegg, Spesiell grafitt, Silisiumkarbid keramikkogAnnen halvleder keramikk. Vetek Semiconductor er opptatt av å tilby avanserte løsninger for forskjellige SIC -wafer -produkter for halvlederindustrien.
Hvis du er interessert i ovennevnte produkter, kan du gjerne kontakte oss direkte.
Mob: +86-180 6922 0752
WhatsApp: +86 180 6922 0752
E -post: anny@veteksemi.com



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Alle rettigheter reservert.
Links | Sitemap | RSS | XML | Personvernerklæring |
