QR kode

Om oss
Produkter
Kontakt oss

Telefon

Faks
+86-579-87223657

E-post

Adresse
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Silisiumepitaksier en avgjørende grunnleggende prosess i moderne halvlederproduksjon. Det refererer til prosessen med å dyrke ett eller flere lag av enkrystall silisium tynne filmer med spesifikk krystallstruktur, tykkelse, dopingkonsentrasjon og type på et nøyaktig polert enkrystall silisiumsubstrat. Denne dyrkede filmen kalles et epitaksialt lag (Epitaxial Layer eller Epi Layer), og en silisiumplate med et epitaksialt lag kalles en epitaksial silisiumplate. Dens kjernekarakteristikk er at det nyvoksede epitaksiale silisiumlaget er en fortsettelse av substratgitterstrukturen i krystallografi, og opprettholder samme krystallorientering som substratet, og danner en perfekt enkeltkrystallstruktur. Dette gjør at det epitaksiale laget kan ha nøyaktig utformede elektriske egenskaper som er forskjellige fra substratets, og gir dermed et grunnlag for produksjon av høyytelses halvlederenheter.
![]()
Vertial epitaksial susceptor for silisium epitaksi
1) Definisjon: Silisiumepitaksi er en teknologi som avsetter silisiumatomer på et enkeltkrystall silisiumsubstrat ved kjemiske eller fysiske metoder og ordner dem i henhold til substratgitterstrukturen for å vokse en ny enkrystall silisiumtynn film.
2) Gittertilpasning: Kjernetrekket er orden i epitaksial vekst. De avsatte silisiumatomene er ikke tilfeldig stablet, men er ordnet i henhold til krystallorienteringen til substratet under veiledning av "malen" gitt av atomene på overflaten av substratet, og oppnår presis replikering på atomnivå. Dette sikrer at det epitaksiale laget er en enkeltkrystall av høy kvalitet, i stedet for polykrystallinsk eller amorft.
3) Kontrollerbarhet: Silisiumepitaksiprosessen tillater presis kontroll av tykkelsen på vekstlaget (fra nanometer til mikrometer), dopingtypen (N-type eller P-type) og dopingkonsentrasjonen. Dette gjør at regioner med forskjellige elektriske egenskaper kan dannes på den samme silisiumplaten, som er nøkkelen til å produsere komplekse integrerte kretser.
4) Grensesnittegenskaper: Det dannes et grensesnitt mellom epitaksiallaget og substratet. Ideelt sett er dette grensesnittet atomisk flatt og forurensningsfritt. Kvaliteten på grensesnittet er imidlertid avgjørende for ytelsen til det epitaksiale laget, og eventuelle defekter eller forurensning kan påvirke den endelige ytelsen til enheten.
Epitaksial vekst av silisium avhenger hovedsakelig av å gi riktig energi og miljø for silisiumatomer å migrere på overflaten av substratet og finne den laveste energigitterposisjonen for kombinasjon. Den mest brukte teknologien for tiden er Chemical Vapor Deposition (CVD).
Kjemisk dampavsetning (CVD): Dette er den vanlige metoden for å oppnå silisiumepitaksi. Dens grunnleggende prinsipper er:
● Forløper transport: Gass som inneholder silisiumelement (forløper), som silan (SiH4), diklorsilan (SiH2Cl2) eller triklorsilan (SiHCl3), og dopinggass (som fosfin PH3 for N-type doping og diboran B2H6 for P-type doping) blandes i kammerreaksjon med høy temperatur og føres inn i kammerreaksjon med høy temperatur.
● Overflatereaksjon: Ved høye temperaturer (vanligvis mellom 900°C og 1200°C), gjennomgår disse gassene kjemisk dekomponering eller reaksjon på overflaten av det oppvarmede silisiumsubstratet. For eksempel SiH4→Si(faststoff)+2H2(gass).
● Overflatemigrasjon og kjernedannelse: Silisiumatomene som produseres ved dekomponering adsorberes til substratoverflaten og migrerer på overflaten, og finner til slutt det rette gitterstedet for å kombineres og begynne å danne en ny singelkrystalllag. Kvaliteten på epitaksial vekst silisium avhenger i stor grad av kontrollen av dette trinnet.
● Lagdelt vekst: Det nylig avsatte atomlaget gjentar kontinuerlig gitterstrukturen til underlaget, vokser lag for lag, og danner et epitaksielt silisiumlag med en bestemt tykkelse.
Nøkkelprosessparametere: Kvaliteten på silisiumepitaksiprosessen er strengt kontrollert, og nøkkelparametrene inkluderer:
● Temperatur: påvirker reaksjonshastigheten, overflatemobiliteten og defektdannelsen.
● Trykk: påvirker gasstransport og reaksjonsvei.
● Gassstrøm og forhold: bestemmer veksthastighet og dopingkonsentrasjon.
● Renhet av underlagets overflate: Enhver forurensning kan være årsaken til defekter.
● Andre teknologier: Selv om CVD er hovedstrømmen, kan teknologier som Molecular Beam Epitaxy (MBE) også brukes for silisiumepitaksi, spesielt i FoU eller spesielle applikasjoner som krever ekstremt høy presisjonskontroll.MBE fordamper silisiumkilder direkte i et miljø med ultrahøyt vakuum, og atom- eller molekylstråler projiseres direkte på underlaget for vekst.
Silisiumepitaksiteknologi har utvidet bruksområdet for silisiummaterialer kraftig og er en uunnværlig del av produksjonen av mange avanserte halvlederenheter.
● CMOS-teknologi: I høyytelses logiske brikker (som CPUer og GPUer) dyrkes ofte et lavdopet (P− eller N−) epitaksielt silisiumlag på et sterkt dopet (P+ eller N+) underlag. Denne epitaksiale silisiumwaferstrukturen kan effektivt undertrykke latch-up-effekten (Latch-up), forbedre enhetens pålitelighet og opprettholde den lave motstanden til underlaget, noe som bidrar til strømledning og varmespredning.
● Bipolare transistorer (BJT) og BiCMOS: I disse enhetene brukes silisiumepitaksi for nøyaktig å konstruere strukturer som base- eller kollektorregionen, og forsterkningen, hastigheten og andre egenskaper til transistoren er optimalisert ved å kontrollere dopingkonsentrasjonen og tykkelsen til det epitaksiale laget.
● Bildesensor (CIS): I noen bildesensorapplikasjoner kan epitaksiale silisiumskiver forbedre den elektriske isolasjonen av piksler, redusere krysstale og optimalisere den fotoelektriske konverteringseffektiviteten. Det epitaksiale laget gir et renere og mindre defekt aktivt område.
● Avanserte prosessnoder: Ettersom enhetsstørrelsen fortsetter å krympe, blir kravene til materialegenskaper høyere og høyere. Silisiumepitaksiteknologi, inkludert selektiv epitaksial vekst (SEG), brukes til å dyrke anstrengt silisium eller silisiumgermanium (SiGe) epitaksiale lag i spesifikke områder for å forbedre bærermobiliteten og dermed øke hastigheten til transistorer.
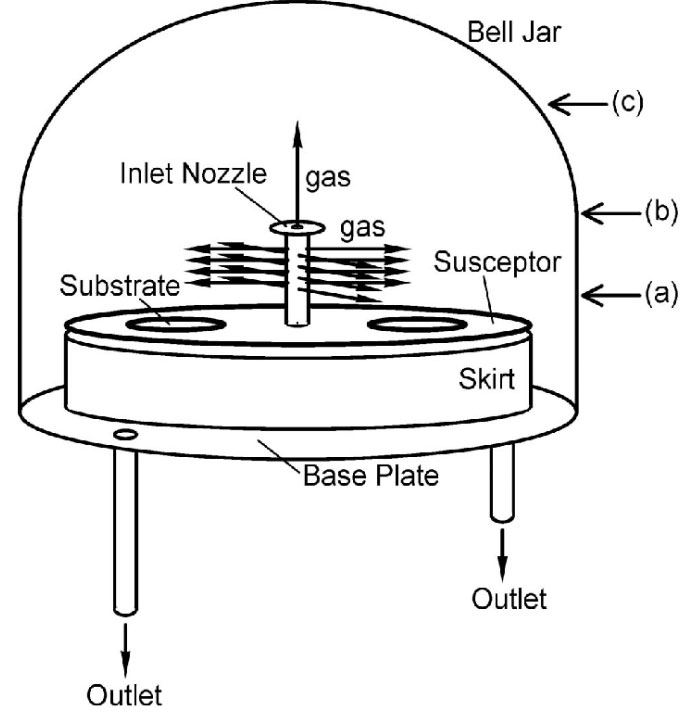
Horisontal epitaksial susceptor for silisium epitaksi
Selv om silisiumepitaksiteknologi er moden og mye brukt, er det fortsatt noen utfordringer og problemer i den epitaksiale veksten av silisiumprosessen:
● Defektkontroll: Ulike krystalldefekter som stablingsfeil, forskyvninger, glidelinjer osv. kan genereres under epitaksial vekst. Disse defektene kan alvorlig påvirke den elektriske ytelsen, påliteligheten og ytelsen til enheten. Å kontrollere defekter krever et ekstremt rent miljø, optimaliserte prosessparametere og underlag av høy kvalitet.
● Ensartethet: Å oppnå perfekt ensartethet av epitaksial lagtykkelse og dopingkonsentrasjon på store silisiumskiver (som 300 mm) er en kontinuerlig utfordring. Uensartethet kan føre til forskjeller i enhetsytelse på samme wafer.
● Autodoping: Under den epitaksiale vekstprosessen kan høykonsentrasjonsdopanter i substratet komme inn i det voksende epitaksiale laget gjennom gassfasediffusjon eller faststoffdiffusjon, noe som fører til at dopingkonsentrasjonen i epitaksiallaget avviker fra forventet verdi, spesielt nær grenseflaten mellom epitaksiallaget og substratet. Dette er et av problemene som må tas opp i silisiumepitaksiprosessen.
● Overflatemorfologi: Overflaten til epitaksiallaget må forbli svært flat, og eventuelle ruheter eller overflatedefekter (som uklarhet) vil påvirke påfølgende prosesser som litografi.
● Koste: Sammenlignet med vanlige polerte silisiumskiver, gir produksjonen av epitaksiale silisiumskiver ytterligere prosesstrinn og utstyrsinvesteringer, noe som resulterer i høyere kostnader.
● Utfordringer ved selektiv epitaksi: I avanserte prosesser stiller selektiv epitaksial vekst (vekst kun i spesifikke områder) høyere krav til prosesskontroll, som selektivitet av veksthastighet, kontroll av sideovervekst, etc.
Som en nøkkel halvledermateriale forberedelse teknologi, kjernen funksjon avsilisium epitaksier evnen til nøyaktig å dyrke høykvalitets enkrystall epitaksiale silisiumlag med spesifikke elektriske og fysiske egenskaper på enkeltkrystall silisiumsubstrater. Gjennom presis kontroll av parametere som temperatur, trykk og luftstrøm i silisiumepitaksiprosessen, kan lagtykkelsen og dopingfordelingen tilpasses for å møte behovene til ulike halvlederapplikasjoner som CMOS, strømenheter og sensorer.
Selv om epitaksiell vekst av silisium står overfor utfordringer som defektkontroll, ensartethet, selvdoping og kostnader, med den kontinuerlige utviklingen av teknologi, er silisiumepitaksi fortsatt en av kjernedrivkreftene for å fremme ytelsesforbedring og funksjonell innovasjon av halvlederenheter, og dens posisjon i produksjon av epitaksial silisiumwafer er uutskiftbar.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Copyright © 2024 VeTek Semiconductor Technology Co., Ltd. Med enerett.
Links | Sitemap | RSS | XML | Privacy Policy |
